透過表面特性分析控制環氧樹脂晶片黏合
在環氧樹脂晶片黏著及任何相關晶片貼合製程中,晶片的精準定位與固定對於製程穩定性及最終元件品質至關重要。黏著劑厚度(亦稱黏著線厚度BLT)是實現晶片與引線框架或其他基板可靠貼合的關鍵因素。
TopMap Polytec的表面轮廓仪s可自動且可靠地測定晶粒在引線框架上的取向(含晶粒傾斜角度),並同步執行鍵合線厚度量測。此非接觸式測量技術能為晶粒鍵合製程提供快速、簡便且可靠的品質管控。
QFN封裝特性分析(四邊扁平無引腳封裝)
Polytec的3D表面測量解決方案可輕鬆整合至生產線,在環氧樹脂晶片黏著製程中提供自動化高解析度製程內測量。典型測量項目包含晶片傾斜角度判定、黏著線厚度測量(BLT)、黏著線高度或晶片定位,以及扭轉資訊與相對於基準位置的相對測量。
在四邊平整無引線封裝(QFN)——作為積體電路中典型的晶片連接類型之一——中,晶片黏著填角是晶片邊緣的額外爬升結構,能提供沿晶片邊緣的機械強度。根據測得的黏著線厚度,可推導出實用且優化的參數,例如填角寬度、填角距焊盤高度、填角上升斜率或斜率角度。
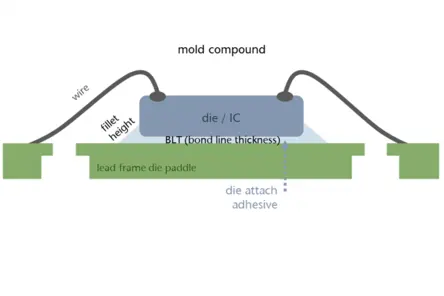
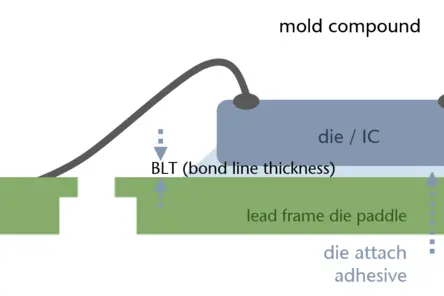
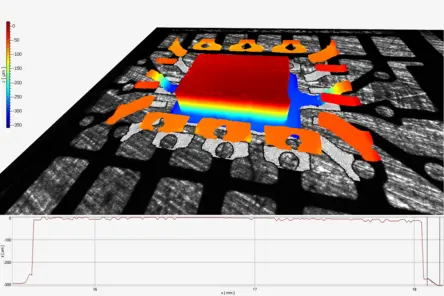
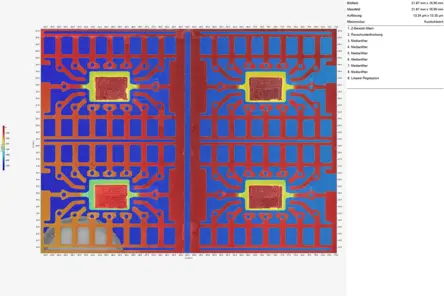

黏合線厚度、薄膜與層厚之三維測量
安裝表面轮廓仪

微型分析儀
Micro.View systems are optimized for ultra-high-resolution measurements in the sub-nanometer range. With focused optics and high vertical resolution they enable detailed analysis of microstructures, surface finish and material distribution where even the smallest deviations matter.

巨觀分析器
Pro.Surf凭借其区域地形扫描技术,能更快地确定形状与平整度。其大Z轴范围的同轴光学系统可探测孔洞与凹陷表面,最大视场与真实拼接功能轻松应对大型样品及多样品测量。升级至Pro.Surf+,更可实现粗糙度分析一体化操作。

Metro.Lab
Metro.Lab是一款紧凑型广域表面轮廓仪。它将卓越的测量性能与小巧的占地面积完美结合,特别适用于空间或预算受限但仍需可靠3D表面数据的应用场景。
選擇合適的表面處理方案,請放心選用轮廓仪 ——透過我們的「先試用後購買」方案,讓您輕鬆獲益。