白光干涉测量:面型光学三维形貌测量技术
现代白光干涉仪借助样本与高精度参考镜的反射光叠加,产生干涉效应来测量。这种测量基于迈克尔逊干涉原理,光路中的光源相干长度在 μm 量级。
准直光束经分光镜,分为测量、参考两束光,前者射向被测样本,后者射向反射镜。二者的反射光在分光镜处汇聚,随后聚焦到相机上。
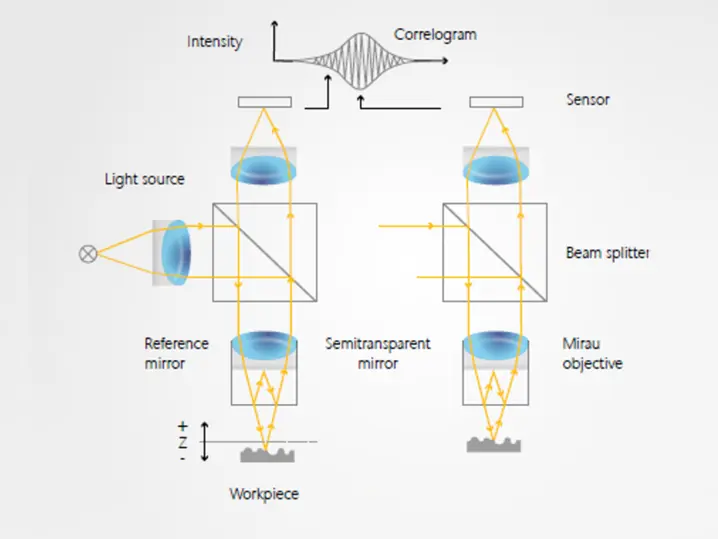
测量光路里,物体点光程与参考光路光程相等时,光源各波长发生相长干涉,对应相机像素强度最高。光程不同时,像素强度较低,相机借此记录同一高度的图像点。
远心光路配置的大面积测量系统,单次测量就能快速扫描大面积表面形貌。而参考光路集成于镜头的显微镜式光学轮廓仪,更适合获取整个区域的横向细节。
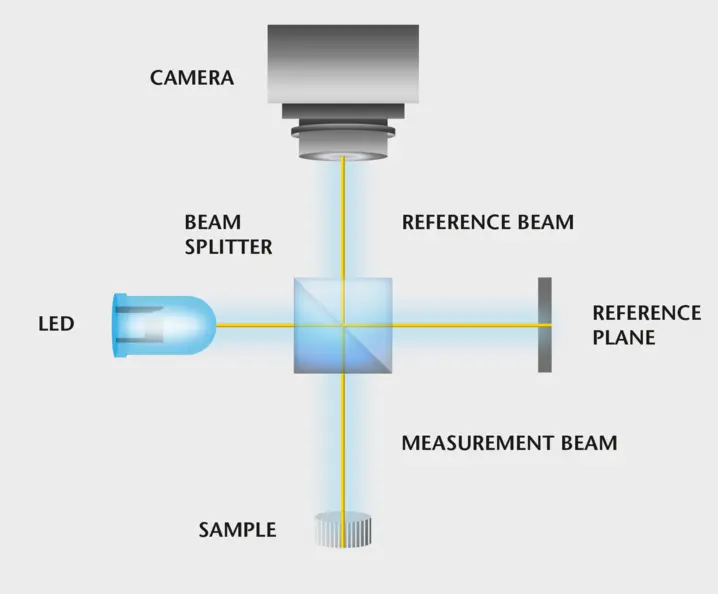
白光干涉测量法(相干扫描干涉测量法)基本原理
白光干涉技術在表面測量學中的優勢
相較於接觸式/探針法,白光干涉儀(WLI)能依照ISO 25178標準測量真實的平面(3D)粗糙度,透過單次掃描即可捕捉各向異性與複雜紋理,生成數百萬個數據點——因此在生產節拍時間內,您能獲得比線性探針測量更高的空間採樣率與更強的統計效力。
由於採用非接觸式設計,WLI可避免探針卷積與磨損問題(無損軟質或鍍膜光學元件),同時提供可重複的奈米級垂直精度;然而在僅需輪廓規格的應用場景,或生產品質保證中需快速、經濟地檢測Ra與Rz等參數時,探針輪廓儀仍具價值。此外,相較於其他非接觸技術,WLI具備多重優勢。
垂直分辨率与视场无关
使用白光干涉测量法(相干扫描干涉测量法)进行平面测量时,垂直分辨率并不取决于所选的物镜。白光干涉测量法是唯一一种分辨率与视场无关的测量方法。

我們的白光干涉儀產品組合

微型分析儀
Micro.View systems are optimized for ultra-high-resolution measurements in the sub-nanometer range. With focused optics and high vertical resolution they enable detailed analysis of microstructures, surface finish and material distribution where even the smallest deviations matter.

巨觀分析器
Pro.Surf凭借其区域地形扫描技术,能更快地确定形状与平整度。其大Z轴范围的同轴光学系统可探测孔洞与凹陷表面,最大视场与真实拼接功能轻松应对大型样品及多样品测量。升级至Pro.Surf+,更可实现粗糙度分析一体化操作。

Metro.Lab
Metro.Lab是一款紧凑型广域表面轮廓仪。它将卓越的测量性能与小巧的占地面积完美结合,特别适用于空间或预算受限但仍需可靠3D表面数据的应用场景。
選擇合適的表面處理方案,請放心選用轮廓仪 ——透過我們的「先試用後購買」方案,讓您輕鬆獲益。

技术指南:光学表面形貌测量方法的优劣势剖析
在本次技术对比环节,您将全面了解四种常用表面测量方法的特性。对比内容涵盖垂直与横向分辨率,在光滑表面测量、粗糙度分析方面的适配场景,以及拼接或非拼接模式下的表现,助您明晰每种方法的优势与短板 。
- 白光干涉测量法
- 共聚焦显微镜技术
- 聚焦变化测量法
- 色散共焦传感器技术

相關報導

专访阿尔贝特・韦肯曼教授:光学与接触式表面测量技术
我们与德国埃尔朗根 - 纽伦堡大学的阿尔贝特・韦肯曼教授进行了交流,探讨了接触式表面测量技术的局限性以及非接触式测量方法的应用前景。

Overview of optical methods for surface metrology
For applications where tactile surface measurement techniques have shortcomings, non-contact optical instruments have been developed to overcome these shortcomings. Especially with the development of compu…

相干扫描干涉测量技术(CSI)
了解相干掃描干涉儀(CSI)的光學技術如何分析地形、形狀與粗糙度,並與相關光學表面檢測方法相比,其優勢所在、最佳應用點及實際應用範疇。

