Prozesskontrolle beim Drahtbonden durch optische Messtechnik
Das Drahtbonden ist ein zentraler Fügeschritt in der Elektronik- und Halbleiterfertigung. Die Qualität der Drahtverbindungen beeinflusst maßgeblich die elektrische Funktion, mechanische Stabilität und Lebensdauer elektronischer Bauteile. Bereits kleinste Abweichungen bei Drahtlage, Bondhöhe oder Bondgeometrie können zu Kontaktproblemen oder vorzeitigem Ausfall führen.
Optische 3D-Oberflächenmesstechnik von Polytec unterstützt Hersteller dabei, Drahtbondprozesse zuverlässig zu überwachen. Sie ermöglicht eine berührungslose, flächenhafte Erfassung der relevanten Geometrieparameter – reproduzierbar, hochauflösend und sowohl im Labor als auch in der Produktion einsetzbar.
Typische Messaufgaben beim Drahtbonden
Mit optischer Oberflächenmesstechnik lassen sich unter anderem folgende Qualitätsmerkmale zuverlässig prüfen:
- Draht- und Bondhöhe
- Geometrie und Form der Bondpads
- Lagegenauigkeit und Positionierung der Drahtverbindungen
- Ebenheit und Koplanarität der Kontaktflächen
- Analyse von Bonddefekten und Prozessabweichungen
Die flächenhafte 3D-Erfassung liefert dabei deutlich mehr Information als rein profilbasierte Messverfahren und erleichtert die objektive OK/NOK-Bewertung.
Vorteile der flächenhaften 3D-Oberflächenanalyse
Im Vergleich zu klassischen taktilen oder rein zweidimensionalen Prüfmethoden bietet die optische 3D-Messtechnik entscheidende Vorteile:
- Berührungslose Messung empfindlicher Bondstrukturen
- Hohe Wiederholgenauigkeit auch bei komplexen Geometrien
- Flächenhafte Datengrundlage für belastbare Prozessanalysen
- Schnelle Integration in automatisierte Fertigungsabläufe
So lassen sich Prozessfenster enger definieren, Ausschuss reduzieren und die Gesamtqualität nachhaltig verbessern.
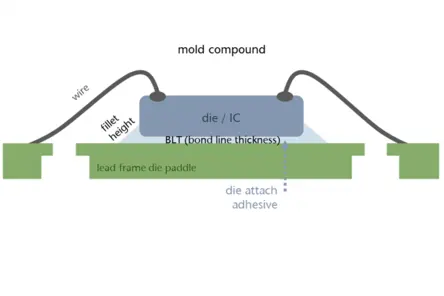
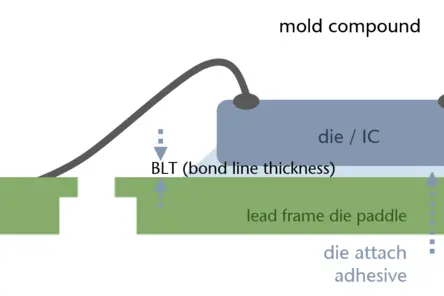
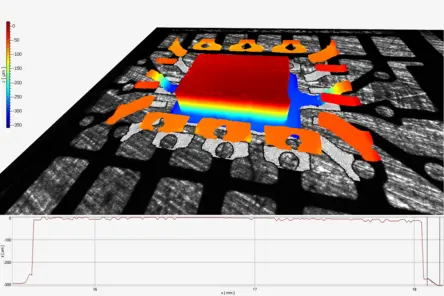
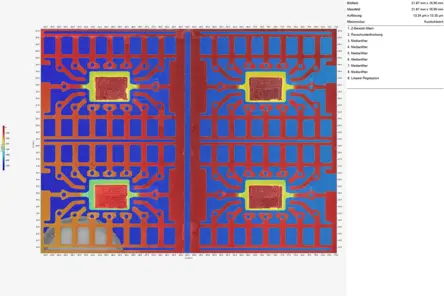

Messung der Klebstoffraupendicke, Film- und Schichtdicke in 3D-Messung
Passende Messsysteme für Drahtbond-Anwendungen

Micro Profilometer
Micro.View Profilometer messen Rauheit, Textur, Mikrostrukturen und Finish mit sub-nm Auflösung. Mit fokussierter Optik und hoher vertikaler Auflösung ermöglichen sie eine detaillierte Analyse der Oberflächenbeschaffenheit und Materialverteilung und dort, wo kleinste Details den Unterschied ausmachen.

Macro Profilometer
Pro.Surf scannen großflächig und bestimmen Form und Ebenheit schneller. Die telezentrische Optik mit großem Z-Bereich meistert selbst hohe Stufen und tiefliegende Bereiche wie Bohrungen. Mit größtem Bildfeld und True Stitching misst es große Prüflinge, Trays oder mehrere Bauteile in einem Schuss. Pro.Surf+ erweitert die Möglichkeiten um eine zusätzliche Rauheitsauswertung.

Metro.Lab
Metro.Lab ist ein kompakter Tisch-Oberflächenprofiler für schnelle, großflächige 3D-Messungen. Hohe Messleistung bei geringer Stellfläche – ideal, wenn Platz oder Budget begrenzt sind, aber zuverlässige 3D-Oberflächendaten gebraucht werden.
Überzeugen Sie sich vor dem Kauf von der Leistung eines Profilers – nutzen Sie unseren „Try before buy“ Ansatz.

Verwandte Anwendungen und Messaufgaben
Besprechen Sie Ihre Anforderungen mit unseren Experten
Gerne erfahren wir mehr über Ihre Bauteile, Toleranzen und Herausforderungen. Basierend darauf können wir Empfehlungen zu Technologien und Systemen geben. Oder wir zeigen Ihnen in einer kurzen Demo, wie einfach und effizient Messungen mit dem passenden Polytec Profilometer durchgeführt werden – entweder an unseren Komponenten oder direkt an Ihrem Bauteil.